熱門資訊> 正文
替代EUV光刻機光源,日本方案詳解
2024-06-23 10:07
本文來自格隆匯專欄:半導體行業觀察;作者: Norio等
1
引言
衆所周知,根據摩爾定律,每塊芯片的晶體管數量幾乎每兩年翻一番。光刻分辨率R取決於光源波長λ、數值孔徑NA和工藝參數 k1,如下所示、

爲了保持摩爾定律的有效性,光源波長逐漸變得越來越短,這是因為分辨率與波長成線性比例。EUV光刻波長為13.5 nm,符合Mo/Si多層反射鏡的反射率。幾年前爲了實現高批量生產(HVM),在EUV光刻技術中開始使用250 W激光產生的等離子體(LPP)源。在LPP光源中,由CO2驅動激光器和錫液滴產生的錫等離子體為具有EUV光源的光刻機系統提供強烈的EUV光。錫的碎屑對反射式集光鏡的污染是該系統的主要問題之一。EUV光刻的另一個問題是隨機效應。在極紫外光刻技術中,由於光子能量高得多,在相同劑量下,晶片上單位面積吸收的光子數要比準分子激光器少得多。如果曝光能量不足,晶圓上會出現隨機圖案缺陷。爲了抑制在很高產能吞吐量的情況下的EUV隨機效應,需要很高的EUV功率。對於未來光刻機的最大產能吞吐量,需要估算出減輕隨機效應所需的EUV功率。3nm節點所需的EUV功率大於1.5 kW, 2nm節點所需的EUV功率大於2.8 kW。因此,未來EUV光刻技術將需要更強大的EUV光源。
自由電子激光器(FELs)大致分為兩種類型,即振盪器型FEL和自發輻射(SASE)型FEL。在振盪器型FEL中,來自電子加速器的電子束在一個螺旋波管內發出光,與振盪器中存儲的光相互作用,並放大FEL光。然而,由於短波光的鏡面反射率較低,諧振型FEL的波長被限制在大約100納米以上。在自發輻射SASE型FEL中,高質量的電子束通過加速器自發輻射,在一個波盪管內自放大,無需振盪器和外部種子光。這種類型特別適用於EUV自由電子激光(EUV-FEL)等短波長FEL。用於SASE-FEL的線性加速器(直線加速器)也分為兩種,即常規導體(NC)和超導體(SC)直線加速器。常規導體直線加速器用於許多FEL設施,如LCLS、SACLA、FERMI、SwissFEL、PAL-XFEL等,但電子束的平均電流受熱負荷限制,通常不超過約100 nA,以避免加速器腔體的變形。相比之下,超導體直線加速器由於熱負荷極低,具有更高的束團重複頻率和平均電流(通常為幾十微安),目前在FLASH和European XFEL中運行,並將用於LCLS-II和SHINE項目。超導體直線加速器更適合高功率FEL。
能量回收線性加速器(ERLs)相比上述沒有能量回收的普通直線加速器,能提供更強大的FEL驅動能力。圖1顯示了普通直線加速器和ERL的示意圖。在普通直線加速器中,加速的電子束在FEL發射后立即被拋棄。相比之下,在ERL中,通過循環迴路將加速的電子束返回主直線加速器,減速至接近初始注入能量,進行能量回收,然后拋棄電子束。注入器中的低能量束和循環迴路中的高能量束交替通過主直線加速器的加速和減速RF射頻階段。因此,主直線加速器中的加速能量得到回收,拋棄的束團功率和活化電子被大幅減少。因此作為結果,ERL可以實現更高的束團重複頻率和平均電流(通常為0.1到10毫安),以提供更高的FEL功率。目前或曾經運行的幾個10至160兆電子伏特的ERL包括Jefferson Laboratory的ERL-FEL、BINP的Novosibirsk ERL和Daresbury Laboratory的ALICE。例如,Jefferson Laboratory的ERL FEL通過使用諧振型FEL,實現了超過10千瓦的紅外功率。基於ERL的EUV-FEL可以通過使用能量回收方案和超導加速器技術,克服當前EUV光刻的問題,成為最強大的EUV光源。
本文設計並研究了一種基於ERL的EUV-FEL光源,用於未來光刻,並在前面的文章中闡明瞭EUV-FEL光源的設計理念和未來前景。本文在概述了EUV-FEL光源的基礎上,重點闡述了EUV-FEL光源的優勢特點,從而清晰全面地展示了EUV-FEL光源與LPP光源的區別。EUV-FEL光源極高的功率性能是通過一種全新的從頭到尾全面仿真來預測得到的。通過仿真計算得到的EUV功率明顯高於以往發表的文章所述。光束線中關鍵組件的概念設計,其中強烈的FEL光從EUV-FEL傳遞到多個光刻機。此外,提出了可能的BEUV- fel升級方案,並將模擬的BEUV- fel光譜與BEUV多層鏡面的實測反射率曲線進行了比較。本文還強調了在High-NA光刻中,對FEL光的偏振控制對於充分利用偏振效應是非常重要的,通過我們所提出的方案可以通過保持較高的FEL增益和功率來實現。此外,還估算了EUV FEL光源的電力消耗、建設和運行成本,並與LPP光源進行了比較。本文還介紹了使用緊湊型ERL (cERL) IR-FEL的EUV-FEL光源的概念驗證(PoC)和PoC演示的重大進展。最后簡要介紹了cERL未來大功率FEL操作的最新進展。

圖1所示。(a)普通直線和(b) ERL的示意圖。在ERL中,加速束流在FEL發射后以RF減速階段返回主直線加速器以恢復加速能量,在減速后被傾倒到注入能量,而在普通直線加速器中,加速束流在FEL發射后立即被傾倒而不恢復能量。
2
用於未來光刻的EUV-FEL光源
2.1 概述
我們設計並研究了基於ERL的高功率EUV-FEL光源。圖2展示了EUV-FEL光源的示意圖和設計參數。在該光源中,由電子槍產生的電子束,帶電量為60皮庫侖,以162.5兆赫的束團重複頻率進行加速,首先在注入器超導線性加速器中加速至約11兆電子伏特,然后在主超導線性加速器中加速至800兆電子伏特。加速的束團在第一彎曲段通過磁束聚縮進行縱向壓縮,以便在迴旋加速器中的多個螺旋波管系統中產生高功率的EUV光。在FEL激射后,電子束通過第二彎曲段在減速的RF相位返回主超導線性加速器,然后在主加速器中進行能量回收,並在束流轉儲處傾倒。通過這種能量回收方案,實現了高達10毫安的平均電流,以提供超過10千瓦的高功率EUV光。主加速器具有64個9腔超導腔體,加速梯度為12.5兆伏每米或更高。注入器和主加速器的射頻頻率為1.3GHz,是束團重複頻率的八倍。

.圖2顯示了基於ERL的EUV-FEL光源的示意圖和設計參數。電子束帶電量為60皮庫侖,束團重複頻率為162.5兆赫,經過加速達到800兆電子伏特,並通過迴旋產生超過10千瓦的高功率EUV光。在FEL激射后,電子束返回主超導線性加速器進行能量回收,並在束流拋棄處進行拋棄。
EUV-FEL光源的主要組件包括一個陰極直流電子槍、一個注入器超導腔體、一個主線性加速器超導腔體、一個用於FEL系統的波動器和兩個用於束控和抑制相干同步輻射效應的弧型分段。這些組件中的大部分都在高能加速器研究機構(KEK)進行了研究和開發,基於現有技術進行,以儘快將EUV-FEL光源工業化。關於主要組件的研發細節詳見參考文獻。
與LPP光源相比,EUV-FEL光源具有幾個優點。EUV- FEL光源可以產生超過10 kW的高功率EUV光而不含錫碎屑,因此,它可以同時為10臺光刻機提供超過1 kW的EUV功率,而不會對Mo/Si反射鏡造成錫污染。此外,EUV-FEL可升級為BEUV-FEL,產生更短波長(6.6-6.7 nm)的EUV光源實現更精細的圖案。此外,它還可以對High-NA光刻中FEL光的偏振進行可變控制。此外,還可以降低每臺光刻機的電力消耗和成本。EUV-FEL光源的優點將在下面更詳細地描述。
2.2 高功率性能
圖3和圖4顯示了一個新的EUV-FEL光源的從頭到尾全面模擬結果,以展示其高功率性能。在此模擬中,採用了一種新的噴射器參數優化,以最小化噴射器出口的縱向發射度,而不是橫向發射度。在整個光源中引入縱向空間電荷(SC)效應,使模擬更加精確和真實。仿真中採用的跟蹤粒子數為500k。圖3為注射器出口、主直線加速器加速至800 MeV后的第1電弧入口、第1電弧段磁束壓縮后的FEL入口,束荷為60 pC時的模擬電子束分佈圖。對光源參數進行了優化,使FEL入口處的FEL參數(皮爾斯參數)最大化。束壓縮使電子束在FEL入口處的峰值電流大大提高到700a以上。束長和能量擴散分別為39 fs和0.1%,標準化水平和垂直發射分別為2.0和0.9 mm·mrad。
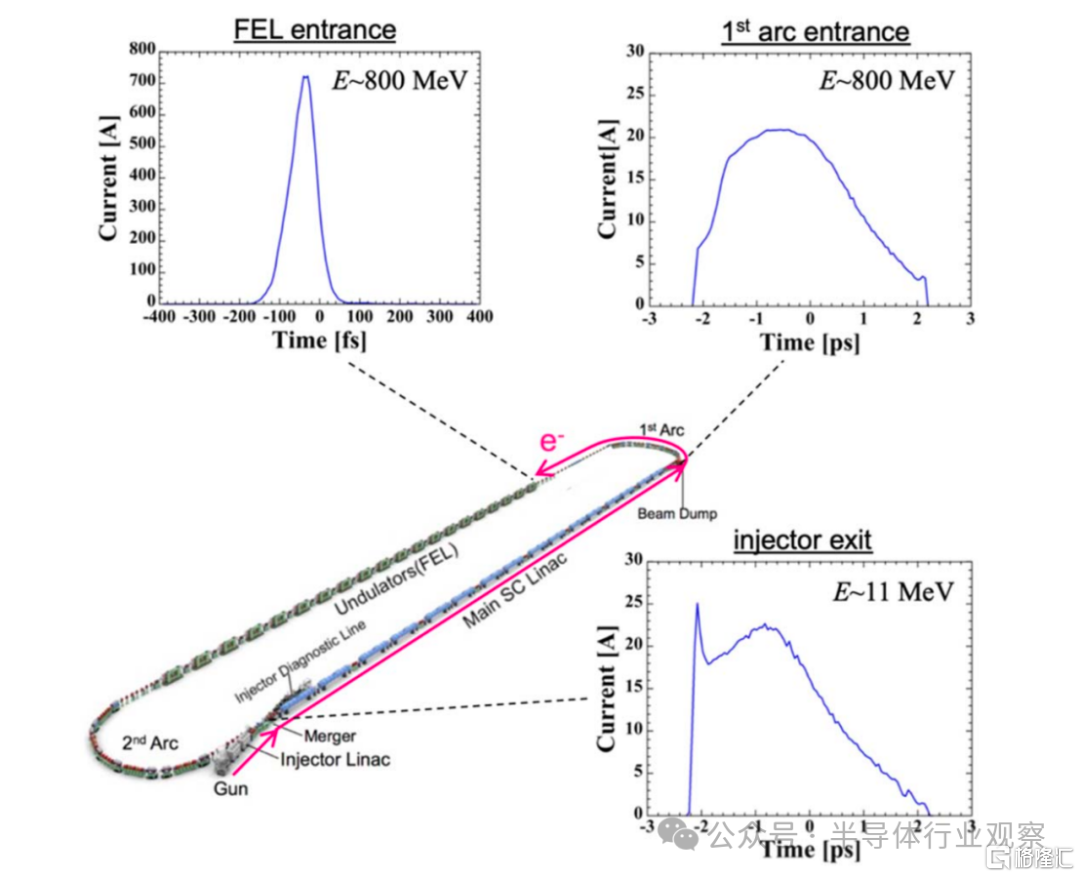
圖3所示。在跟蹤粒子數為50萬的情況下,模擬優化了60 pC束荷在噴射器出口、第一電弧入口和FEL入口的電子束分佈。由於第一電弧段的磁束效應,使FEL入口的峰值電流大大增加到700 A以上。
圖4(a)和圖4(b)顯示了模擬的FEL脈衝每電子束能量與FEL出口的波動器截面長度和FEL功率譜的關係。由於具有FEL波長周期的電子束的微束在波動器中生長,並且微束光束相干地輻射EUV光,因此FEL脈衝能量急劇增加,直到在50 ~ 60 m處達到飽和,如圖4(a)所示。在FEL出口處的脈衝能量為109.4μJ,最佳線性錐度為4%,在約10 mA時,束重頻率為162.5 MHz, FEL功率為17.8 kW。如果束重複頻率可以增加一倍至325 MHz,則EUV功率在約20 mA時增加到35.5 kW。仿真結果表明,EUV-FEL光源具有優良的大功率性能。FEL光譜寬度小於0.1 nm,窄到足以滿足Mo/Si鏡面反射率,如圖4(b)所示。由於FEL的發射,能量擴散從0.1顯著增加到0.34%。然而,在這個模擬中,即使在自由電子激光器經過具有典型孔徑的束流管后,電子束也成功地在沒有任何束流損失的情況下傳輸。採用GPT、GENESIS和ELEGANT三種仿真代碼分別對噴射器、自由電子束流系統以及包括主直線迴路和再循環迴路在內的其他部分進行仿真。對於未考慮的光束動力學和各種誤差的影響,需要進一步的仿真研究。
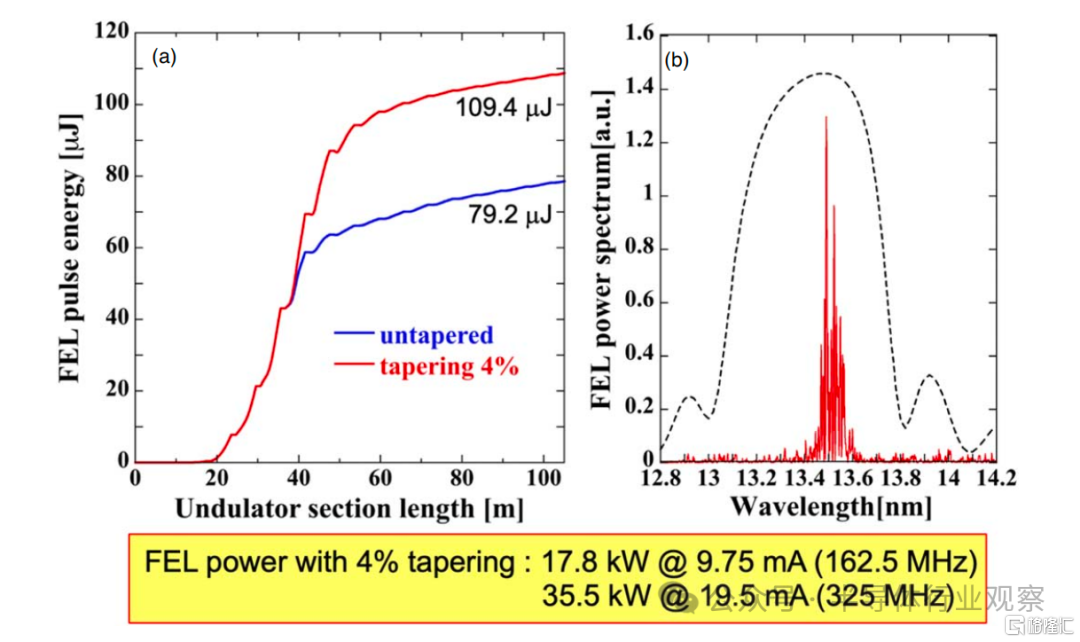
圖4所示。(a)模擬FEL光源每電子束的FEL脈衝能量隨波動器截面長度(無錐度和最佳線性錐度為4%)的函數關係;(b) FEL出口的FEL功率譜。在束重複頻率為162.5 MHz時,計算得到的EUV-FEL功率在9.75 mA時為17.8 kW,在325 MHz時為19.5 mA時為35.5 kW。EUV-FEL光譜的波帶寬度足夠窄,以折線表示的Mo/Si鏡面反射率。
2.3 光學beamline
需要一條光束線將EUV光從EUV- fel光源傳輸到LSI晶圓廠的光刻機。正常入射EUV-FEL光的每脈衝能量密度約為10 mJ cm−2,橫向尺寸為~ 1 mm2,在距離FEL出口3 m處的FWHM半波帶寬度脈衝長度為~ 100 fs。它低於Mo/Si多層和Si的燒蝕閾值,在SACLA-BL1使用兩個光源,等離子體激光器和EUV-FEL實驗估計的燒蝕閾值約為20 mJ cm-2,並且不依賴於脈衝長度小於10ps。此外,在光束線的概念設計中,FEL光首先通過彎曲掠射鏡垂直擴展,然后通過分割的多彎曲鏡水平擴展和分離10個光刻機,如圖5所示。在距離多曲面反射鏡3 m處,極紫外光的能量密度降至約2.5μJcm−2。準直鏡系統對FEL光進行擴展和分離后,可以很好地調節各掃描系統的光斑尺寸。這些反射鏡是全反射鏡,具有非常小的掠射角,可以完全反射EUV光而不會造成燒蝕損傷。因此,來自光源的EUV光被傳輸到每個光刻機系統的第一個Mo/Si反射鏡,沒有明顯的損耗和反射鏡損壞。
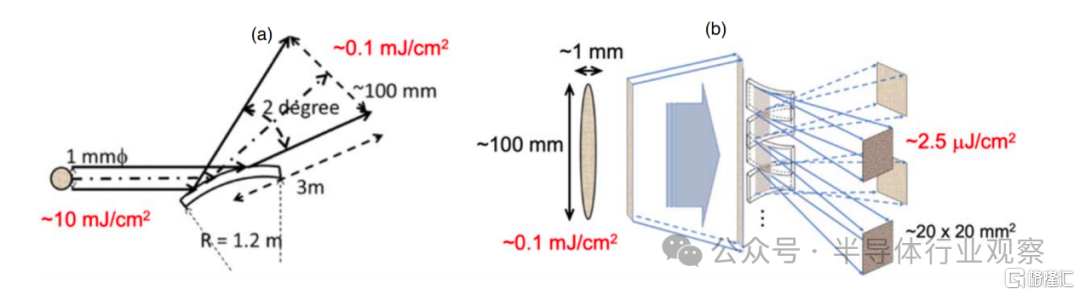
圖5所示。光束線中EUV-FEL光的處理。(a)用小掠射角彎曲掠射鏡垂直擴展EUV-FEL光。(b)分段多曲面反射鏡對EUV-FEL光的水平擴展和分離。光束線上的全反射鏡使自由電子激光器的能量密度從10μjcm−2降低到2.5μJ cm−2。改編自Ref. 9。
2.4 BEUV-FEL的升級方案
圖6(a)至6(c)示意圖顯示了從EUV-FEL光源升級到BEUV-FEL光源的三種可能方案。圖6(a)中的第一種方案非常簡單,基於單迴路佈局。由於在相同的波動周期和場域中,FEL波長與光束能量的平方成反比,因此主直線長度增加倍數約2的平方根,光束能量增加到1.13-1.14 GeV,波長縮短到6.6-6.7 nm,約為EUV波長的一半。由於FEL的飽和長度與光束能量成正比,因此波動器的截面長度也增加了。另外兩種方案是基於雙環佈局,不顯着增加光源長度。在圖6(b)所示的第一個雙迴路佈局中,主直線加速器的總長度增加,但被分成兩部分。需要設計和添加每個主要由三個或四個彎曲磁鐵組成的合併器和擴展器以連接兩個環路,而不會顯著降低波束質量。兩束不同能量的光束由合成器合併,由擴頻器分離。在圖6(c)所示的雙回線佈局中,光束被主直線加速器加速兩次,因此主直線加速器長度不變或可以減小。相反,主直線加速器中的光束電流和熱負荷幾乎增加了一倍。我們可以根據場地尺寸和允許空腔熱負荷等光源條件選擇其中一種。大多數EUV-FEL元件在每種方案中都可以在BEUV-FEL光源中重複使用。圖6(d)顯示了模擬的BEUV-FEL光譜。該光譜的帶寬(~ 0.04 nm)比圖6(e).21中測量的BEUV反射鏡反射率窄,這意味着基於ERL的FEL也是BEUV光刻的有前途的光源。
2.5 偏振控制
FEL光的偏振特性可用於High-NA光刻。如式(1)所示,光刻分辨率與NA成反比,即使光源波長不變,NA越高,分辨率也越高。圖7(a)和7(b)顯示了兩個平面波在High-NA配置下以不同路徑傳播的示意圖,以及兩個波的相互干涉產生的光強度作為s偏振和p偏振模式在晶圓上位置的函數。

其中,θ為入射角,n為折射率,x為焦平面上的水平位置,I0為每個入射平面波的強度。NA由n·sinθ定義,n在空氣中等於單位。在s偏振光中,兩個波的電場在x = 0處完全乾涉,因為它們是平行的。另一方面,在p偏振光中,電場只有部分干涉,因為它們有不同的方向。(Imax−Imin)/(Imax +Imin)定義的圖像對比度對於s偏振光為1,對於p偏振光為cos2θ。p偏振光的強度和對比度隨入射角的增大而減小。結果表明,s偏振光在High-NA光刻成像中具有比p偏振光更好的性能。實驗也證實了這種High-NA構型的極化效應。因此,爲了在High-NA光刻中充分利用偏振效應優化成像品質,對FEL光源的偏振控制非常重要。
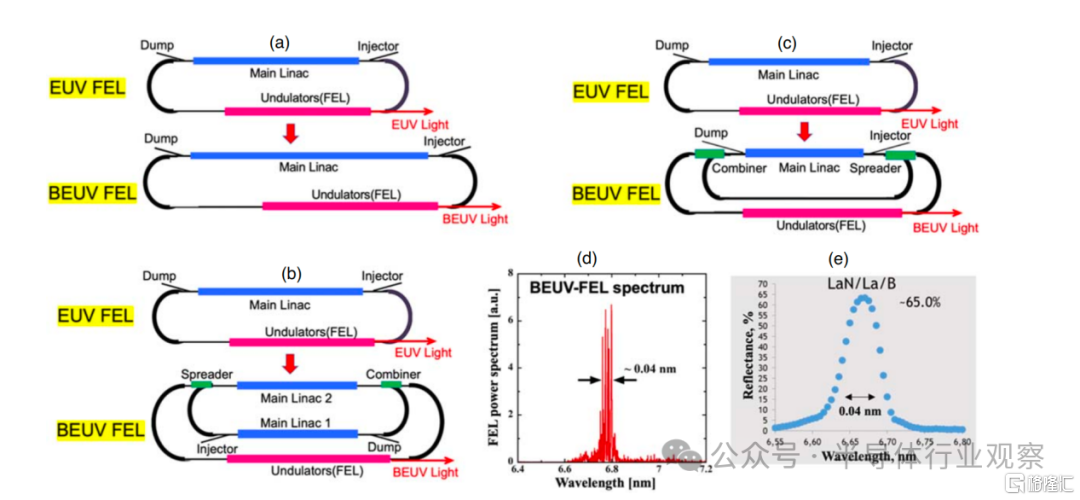
圖6所示。三種可能的BEUV-FEL升級方案基於(a)單環佈局,(b)雙環佈局,主直線加速器分為兩個部分,(c)雙環佈局,使用一半或更短的主直線加速器進行兩次加速。(d)模擬BEUV-FEL光譜。經Ref. 20許可改編。(e)測得的BEUV鏡面反射率。經Ref. 21許可改編。

圖7所示。(a) s偏振和(b) p偏振模式下,兩個平面波在High-NA配置下以不同路徑傳播的示意圖,以及兩個波的干涉所給出的光強隨晶圓上水平位置x的函數。
我們提出了EUVFEL和BEUV-FEL光源的偏振控制方案,如圖8所示。在FEL系統中,大多數的波動器都採用圓極化(螺旋)波動器,以獲得比線性極化波動器更高的FEL增益和功率。另一方面,在最后幾個波動中採用了帶有偏振控制機構的變極化波動器。Apple-2型等可變偏振波動器可以通過滑動四個磁體陣列來控制波動光的偏振,產生水平和垂直的線性偏振以及圓偏振。電子束的微聚束在螺旋波動中生長良好,而來自螺旋波動的FEL光在波動段中丟失和稀釋。從微束光束發出的FEL光的最終偏振狀態主要是由下游的變偏振波動決定的。因此,EUV-FEL和BEUV-FEL光源可以很好地控制High-NA光刻中FEL光的偏振。

圖8所示。EUV-FEL和BEUV-FEL光源的偏振控制方案。在FEL系統中,大多數的波動是圓偏振(螺旋)波動,以獲得更高的FEL增益和功率,最后幾個波動是可變偏振波動,以很好地控制High-NA光刻的FEL光的偏振。
2.6 用電量及成本
在半導體行業,最近推出了可持續半導體技術與系統(SSTS)計劃,因為半導體制造的二氧化碳足跡正在迅速上升。在芯片的技術發展中,環境評分是在芯片功耗、面積、性能、成本等傳統評分基礎上新增的。從這個角度來看,降低EUV光源的電力消耗在EUV光刻中是很重要的,因為LPP光源消耗了EUV光刻機的很大一部分電力。表1顯示了EUV-FEL光源的估計用電量。超導體空腔的冷卻系統使用所有項目中最多的電力。基礎設施包括冷卻水系統、空調系統、照明系統等。總耗電量為10千瓦EUV功率為7兆瓦,因此每1千瓦EUV功率或光刻機消耗0.7兆瓦。相反,LPP光源在250瓦EUV功率下消耗約1.1兆瓦的電力,在1千瓦EUV功率下消耗約4.4兆瓦的電力。雖然應該指出的是,ASML已經逐漸減少了LPP源所需的電力,但EUV- FEL可以大大降低每臺光刻機或1千瓦EUV功率的電力消耗,非常適合SSTS計劃要求。
極紫外光源的成本在芯片的技術發展中也很重要。EUV-FEL光源的建設和運行成本大致估計為每年4億美元和每年4000萬美元用於實現10千瓦的EUV電源,因此每1千瓦EUV或光刻機每年4000萬美元和400萬美元。另一方面,通過簡單的線性外推,LPP光源的建設和運行成本大致估計為每250瓦EUV功率每年2000萬美元和1500萬美元,每1千瓦EUV功率或光刻機每年8000萬美元和6000萬美元。特別是LPP EUV光源的運行成本昂貴,集光器鏡片模組的維護費用佔運行成本的大部分,集儘管集光鏡的使用壽命現在得到了顯着提高,集光器鏡片仍然由於錫屑的污染而逐漸退化,需要定期更換。EUV-FEL光源還可以降低每臺光刻機的建造和運行成本。LPP和EUV-FEL光源之間的成本進行了類似的比較。
3
EUV-FEL使用cERL的PoC
EUV-FEL的PoC演示也很重要。cERL於2014年在KEK建成,並一直用於開發關鍵的ERL技術,如光電陰極直流槍和超導體腔,並展示了ERL作為未來光源和工業應用的卓越性能。在cERL中,已經實現了低束電荷(<6 pC)的平均電流約為1 mA的運行。EUV-FEL的PoC可以通過在cERL中安裝FELbundulators來產生SASE-FEL發射,如圖9所示。波動光的波長λ如下所示:

其中γ為洛倫茲因子,aw為波動器參數的rms,Brms為軸上的rms磁場,λu為波動器的磁周期,me和e為電子質量和電荷,c為光速。由式(4)可知,波長與電子束能量的平方成反比,Ee =γmec2。通常,磁周期為幾釐米,波動參數的均方根在1左右。因此,由於電子束能量低,cERL用FEL波動器產生紅外光來代替極紫外光。到目前為止,只有振盪器FEL在ERL中工作,而SASE-FEL從未在ERL佈局中工作。SASE-FEL通常比振盪器FEL要求更高的峰值電流和電子束質量。如果能夠實現,cERL的IR-FEL將是世界上第一個基於ERL的SASE-FEL,並且可以成為基於ERL的EUV-FEL光源的PoC。束荷設置為60 pC的高束荷,這是激光FEL所需要的,束荷與EUV-FEL光源的束荷相同。
幸運的是,作為NEDO項目,2019年10月至2020年5月在cERL建造了一個IR-FEL,目的是開發高功率中紅外激光器,利用基於分子振動躍遷的光吸收進行高效激光加工。這也可以作為基於ERL的EUV-FEL光源的PoC。包含IR-FEL的cERL佈局如圖10所示。兩個3 m的波動器U1和U2安裝了兩個用於IR-FEL的FEL監視器端口。由於項目預算有限,爲了降低成本,採用磁周期為24 mm的線性極化可調相位波動器(apu)作為FEL波動器。這些波動器可以通過縱向滑動上部磁陣列以固定10 mm的磁隙來改變磁場以改變波長。為節省EUV-FEL光源的成本,未來應開發具有固定間隙的變極化和圓極化apu。每個FEL監視器端口有兩種用於IR-FEL燈的監視器,一個MCT (HgCdTe)探測器和一個能量計(熱釋電傳感器)。電子束能量約為17.5 MeV,波動覆蓋了10 ~ 20μm的FEL波長。此外,由於束流線以束流能量歸一化后的能量接受度在cERL中最小,因此在2020年秋季對cERL束流線進行了改造,以大幅提高束流接受度,避免未來大功率FEL運行中束流損失嚴重。

圖10. 緊圍混凝土輻射屏蔽的cERL佈局。在紅色框架內的IR FEL重建區域,安裝了兩個3米長的螺旋波管,U1和U2,並配備了兩個FEL監視端口。黑色框架內的拋棄線也進行了重建,以提高能量接收度,減少未來高功率FEL操作中的束流損失。此外,還顯示了兩個螺旋波管、U2的FEL監視端口以及新的拋棄線的照片。
圖11顯示了FEL的工作方案。在FEL調試和光束調諧中,我們使用Burst模式,在5hz下重複約1μs的宏脈衝,如圖11(a)所示。未來,我們將在連續模式下進行高功率FEL操作,其中電子束連續重複,如圖11(b)所示。IR-FEL運行束長度控制方案如圖11(c)所示。注入器產生的電子束在主直線加速器中被加速,然后在第一電弧中被磁聚束壓縮,以增加自由電子激光器的峰值電流。在FEL發射后,束在Burst模式下通過第二弧被傾倒到可移動的垃圾場。在連續波模式下,波束在主直線加速器中減速以進行能量回收,然后通過轉儲線將束轉儲到主波束轉儲。在垂直孔徑極窄的波動腔中,通過在上游使用聚焦和軌道校正磁體,在波動段使用波束剖面監測儀,可以很好地調節橫向波束的大小和位置。
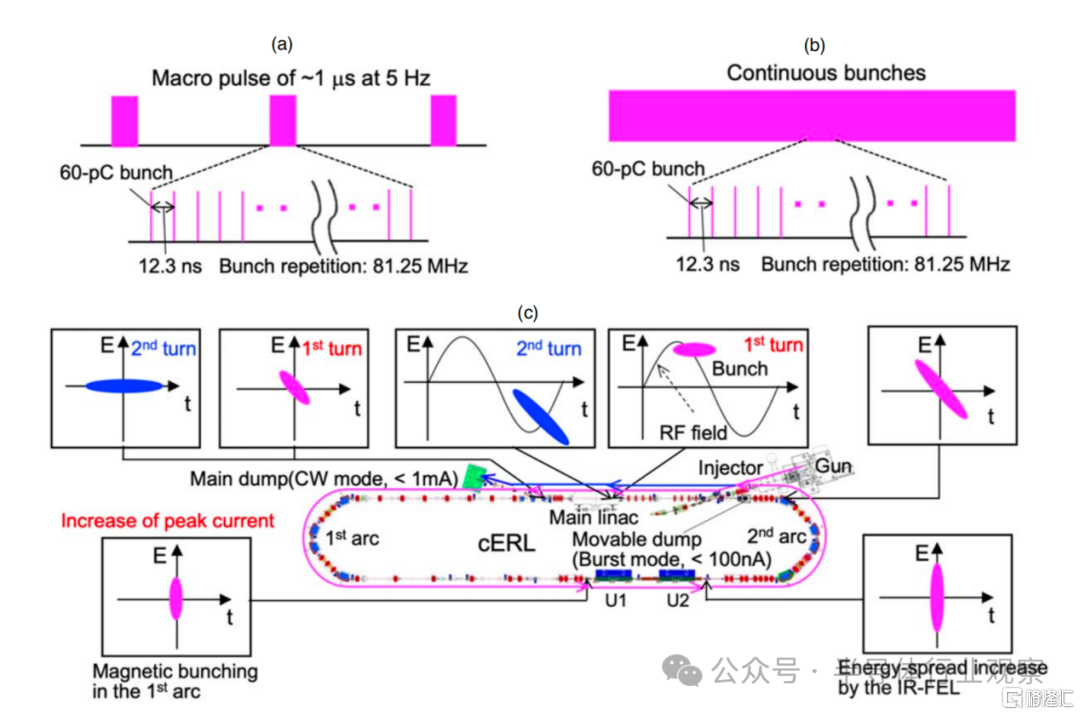
圖11所示。(a)Burst模式和(b)連續模式下cERL電子束的時間結構。(c)串長控制方案。在該方案中,注入器對電子束進行加速,主直線加速器在第一電弧處進行磁聚束壓縮,以提高自由電子激光器的峰值電流。在FEL發射后,電子束被以Burst模式傾倒到活動轉儲中,以CW模式傾倒到主轉儲中。
圖12顯示了2021年2月至3月的FEL調試結果。從圖12(a)可以看出,MCT探測器監測到的U1和U2的FEL強度通過機器學習得到了很好的最大化。圖12(b)和圖12(c)顯示了MCT探測器測得的U1和U2的FEL能量隨時間的變化,以及U1和U2的能量計輸出信號。圖12(d)顯示了在FEL波長為20 μm時,U1和U2的每個電子束的FEL脈衝能量與波動器截面長度的關係。圖中藍色和紅色的線是U1和U2對目標電子束參數模擬的FEL脈衝能量,紅色的兩個圓圈是能量計測量到的U1和U2的FEL脈衝能量。U2的實測FEL能量明顯低於模擬的FEL能量,這是由於束流參數不如目標束流的緣故。造成U2的FEL脈衝能量較低的主要原因是超導效應,它對低能束流的影響很大,我們的模擬研究表明,在cERL中,明顯的超導效應是無法避免的。在電子密度較高的地方,超導體力變得更強,因此,延長了在第一電弧中被磁壓縮的電子束,以增加峰值電流,從而降低了FEL脈衝能量。它們還誘導增加光束的能量擴散和橫向發射。因此,由於超導體效應,在低能量機器(如cERL)中的光束控制和調諧比在高能量機器(如EUV-FEL光源)中更加困難。然而,從圖12(d)中可以看出,考慮到到探測器光路中的空氣吸收,NEDO項目目標的FEL脈衝能量幾乎達到了。在cERL的IR-FEL中,這種顯著的SASE-FEL發射是EUV-FEL的PoC的一個非常重要的步驟。爲了實現未來在連續波模式下的大功率FEL運行,2021年秋季在新的轉儲線上進行了第一次束流輸運研究。2022年2 ~ 3月,在低束電荷和無FEL發射條件下,實現了IR-FEL構建后的第一次大電流運行,最大電流約為250μA,能量回收率為100%。

圖12所示。IR-FEL調試結果。(a)最大化U1和U2的FEL輸出的機器學習示例。經Ref. 32許可改編。(b) MCT探測器U1和U2的FEL能量隨時間的變化。經Ref. 32許可改編。(c) U1、U2電能表輸出信號。(d)在FEL波長20μm處,U1和U2的每電子束FEL脈衝能量隨波動器截面長度的變化。其中藍、紅線為目標光束參數U1和U2的模擬值,兩個紅圈為能量計U1和U2的實測值。綠色的虛線是NEDO項目目標。
4
總結
EUV光刻的HVM量產起始於250W 功率的LPP光源。然而,爲了克服隨機效應以實現更高的曝光能量和更高的NA,未來的EUV光刻將需要更強大的EUV光源。因此,開發更高功率的EUV光源仍具有重要意義。通過能量回收方案,基於ERL的FEL具有極高的FEL功率,是光刻用大功率光源的理想選擇。本項目設計了一種基於ERL的用於未來光刻的EUV-FEL光源,並對主要元件進行了研究和開發。EUV- FEL光源在EUV功率、升級到BEUV-FEL、High-NA光刻偏振控制、功耗和每台掃描儀成本等方面具有許多優勢。通過全面仿真,採用新的優化和更精確的計算,重新證明了EUV-FEL光源具有優異的高功率性能,並研究和提出了升級到BEUV-FEL光源的可能方案或設計、FEL光的偏振控制以及光源到掃描儀的光束線。對EUV-FEL和LPP光源的每台EUV光刻機的電力消耗、結構和運行成本進行了估計,結果發現,通過從LPP光源切換到EUV-FEL光源可以節省這些成本。此外,作為EUV-FEL的PoC的重要步驟,在cERL IR-FEL上實現了顯著的SASE-FEL發射。在未來的高功率自由電子激光器操作方面取得了進一步的進展。EUV自由電子光源被認為是未來光刻最有前途的光源,應進一步推廣產業化。
推薦文章
美股機會日報 | 降息預期升溫!美國1月CPI年率創去年5月來新低;淨利、指引雙超預期!應用材料盤前漲超10%
春節休市提醒 | 港股除夕下午休市,大年初四開市;美股下周一休市一日
千億資金需求下 OpenAI本周在ChatGPT上線廣告
華盛早報 | 美股、金銀全線暴跌,納指跌超2%!韓國人再度掃貨中國股票,大舉買入MINIMAX、瀾起科技;節前央行1萬億元買斷式逆回購來了
美國聯邦貿易委員會:蘋果新聞偏袒左翼媒體、打壓保守派內容
美股機會日報 | 就業數據轉弱!美國至2月7日當周初請失業金人數超預期;存儲概念股盤前齊升,閃迪大漲超7%
要點速遞!《跑贏美股》春節特別直播核心觀點總結
道指「一枝獨秀」連創新高!特朗普喊話還能翻倍,輪動行情下如何平穩「上車」價值股ETF?

